
根据PC Gamer的报道,台积电近日宣布,已正式启动其下一代系统级芯片 (System-on-Wafer, SoW) 封装技术的开发,命名为“SoW-X”。这项创新技术的推出,预计将使当前市场上的中央处理器 (CPU) 和图形处理器 (GPU) 在芯片面积上显得微不足道,为追求极致运算能力的数据中心和人工智能 (AI) 领域带来颠覆性的变革。
报道指出,在当前智能手机、穿戴式设备、移动游戏机,到台式机、服务器,及大型数据中心设备都能看到处理器的身影的情况下,使得芯片的尺寸各异。而当前高端个人计算机中的处理器,无论是AMD的Ryzen 9 9950X3D或Inte l的Core Ultra 9 285K处理器,都已采用了将多个小型芯片 (chiplets) 技术,就是将多个芯片集成封装成一个大型处理器的技术。而台积电的SoW-X技术,正是这种芯片集成概念的更高端实现。
与现有技术相比,SoW-X展现出惊人的规模和集成度。传统的芯片封装技术士通常在约7,000 mm² 的基板上安装三到四个小型晶粒。然而,SoW-X芯片封装技术的覆盖面积将提升10到15倍,甚至需要使用整片12英寸芯片来承载所有组件。而这项技术最引人瞩目的进步之一,在于其能够在同一片芯片上集成更多关键组件。台积电的第一代SoW封装仅将处理晶粒安装到芯片上,而新版本的SoW-X将能够直接包含高带宽内存 (HBM) 芯片。这项突破性的集成技术代表着无需再依赖昂贵,且复杂的外部互联 (interconnects) 来连接内存和处理器,极大的简化了系统设计并提升了效率。
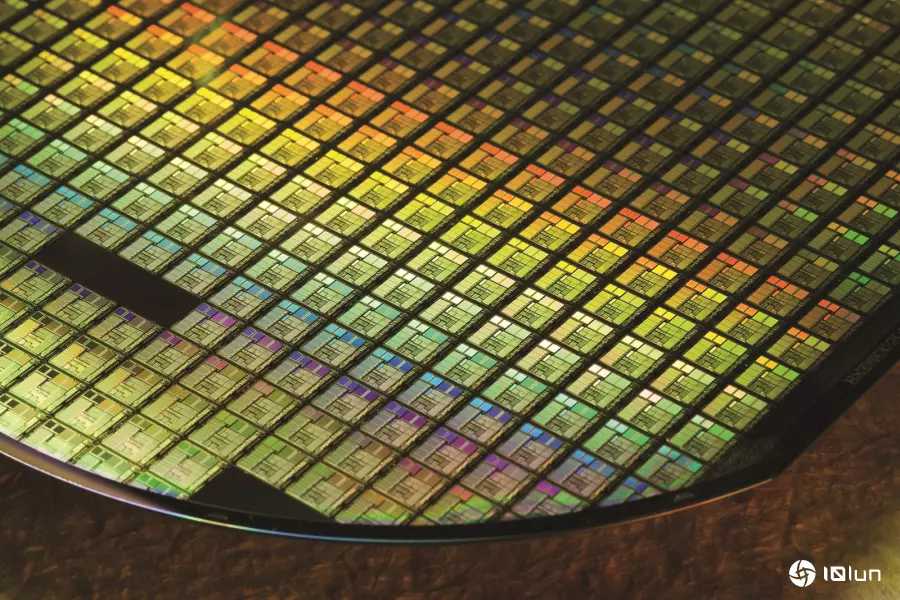
报道指出,为了具体展现SoW-X的庞大规模,即使是目前AMD用于AI应用的大型MI300X处理器,在SoW-X面前也显得异常微小。事实上,AMD的MI300X本身已是一个工程奇迹,因为其中包含20个芯片和晶粒,其中包括四个大型I/O基础晶粒、八个CNDA 3 GPU和八个HBM模块,而台积电的SoW-X有可能将其规模再乘以十倍。
然而,这种庞大的SoW-X产品并非能轻易安装到现有的界面插槽中。由于所有晶粒都安装在同一片芯片上,该芯片必须额外叠加多层结构,以有效散热、提供电力,并在系统内部传输数据。因此,虽然芯片本身是纤薄、精密的对象,但一旦经过SoW-X封装,它们就会变成庞大、沉重且巨大的设备。因此,SoW-X的主要应用场景将锁定在超大型AI数据中心中,在这些对运算密度有着极高要求的环境中,如何在最小的空间内塞入最多的处理能力,是最大化数据中心设备内部可用空间关键。如此,SoW-X不仅仅是为了制造更大、更好的处理器,它更是将摩尔定律 (Moore's Law) 的极限推向新的高峰。
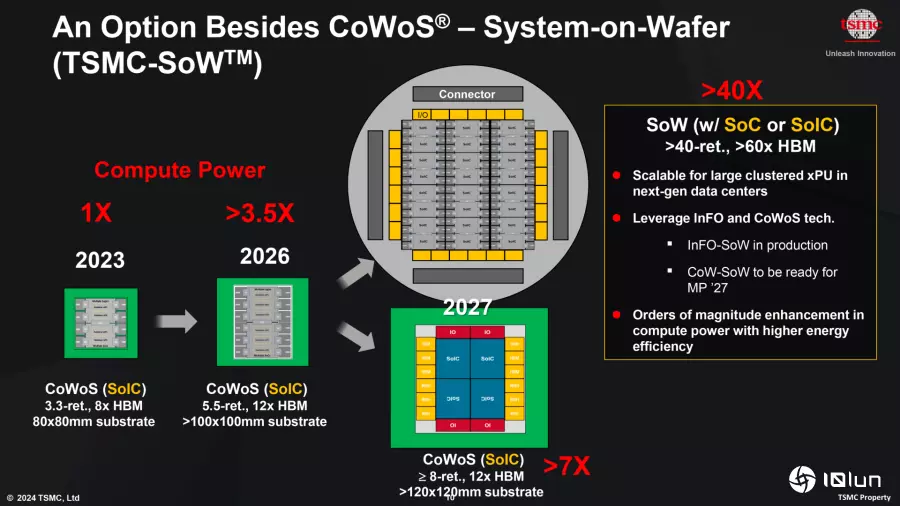
报道强调,除了追求绝对的运算性能,SoW-X在能源效率方面也带来了显著的改善。借由尽可能将多的组件放置在同一个基板上,可以大幅降低功耗。尽管台积电指出SoW-X的总功耗将高达17,000瓦,但其相对性能功耗比 (performance-per-watt) 却比传统通过PCIe界面连接所有组件的数据中心集群高出65%,这代表着在提供相同,甚至更高运算能力的同时,SoW-X能够更有效地利用能源。
因此,对于广大游戏玩家和普通家庭用户而言,SoW-X目前可能看似遥远。然而,台积电通过SoW-X系统开发和出货所积累的知识与经验,将会逐渐下放到其日常的封装产品中。这代表着未来的手机、桌面CPU和显卡都将受益于此,无论它们目前是否已采用晶粒,或芯片堆栈技术,还是在节点制程达到单一晶粒晶体管数量的实际限制时。
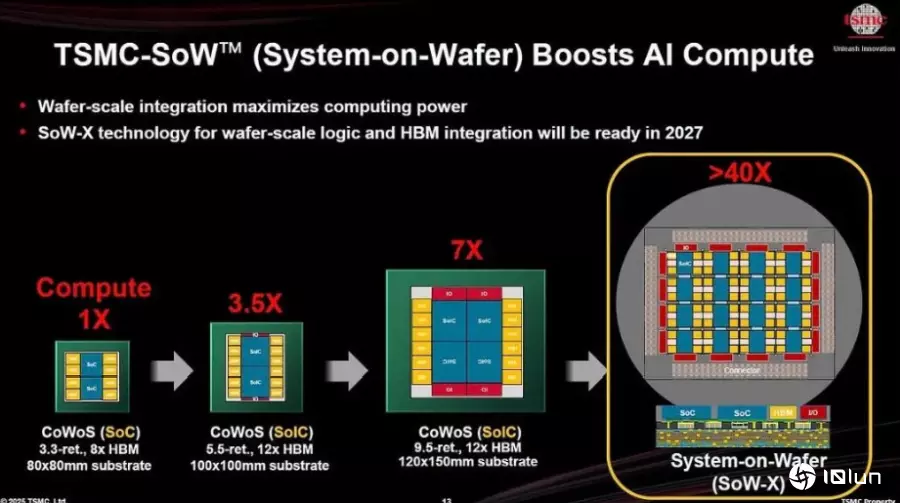
根据台积电的预期,SoW-X在2027年才会正式问世。届时,由于其非常高昂的制造成本,将只有少数特定的客户才能负担得起。这项技术的问世,也引发了业界对未来芯片发展方向的思考,那就是SoW-X之后,芯片是否需要变得更大?或者我们将看到系统级芯片叠芯片 (system-on-wafer-on-wafer) 的发展,以继续推动对更强大处理能力的追求。
报道进一步指出,尽管晶体管的尺寸可能无法再大幅缩小,但可以肯定的是,未来的处理器将会变得巨大得多。台积电持续在芯片技术的突破,最终将会是不需要挑选合作伙伴,只需耐心等待,因为最终所有客户都会找来门来。这也将使得在台积电预计2025年获利将突破500亿美元的背景下,SoW-X的推出,无疑再次巩固了其在全球半导体制造领域的领导地位。
(首图来源:shutterstock)










