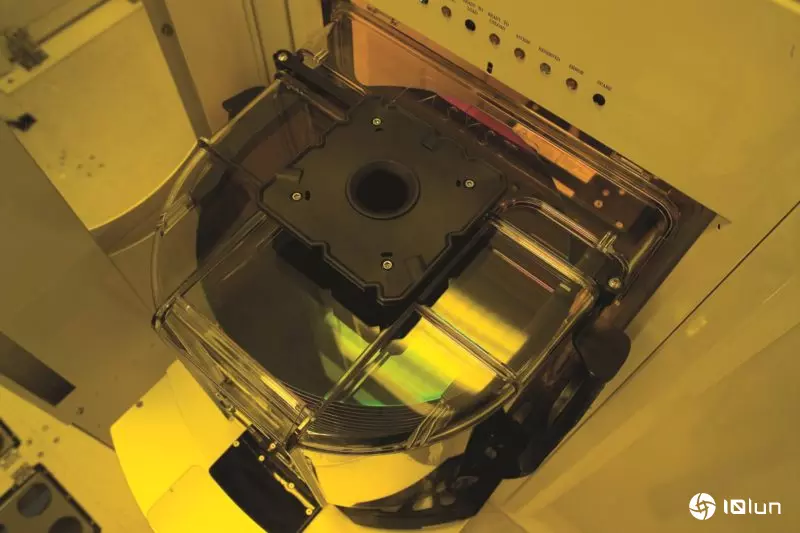
NVIDIA下一代Rubin AI架构传将采用SoIC(System-on-Integrated Chip)封装技术,也将是该公司首款采用Chiplet设计的GPU。市场期待,台积电SoIC有望取代CoWoS成为市场新焦点,预期需求将大幅增长。
随着NVIDIA Rubin架构登场,不仅重新设计架构,还集成HBM4等业界领先的零部件。台积电已开始加速在台湾建设新厂,将重心从现有的先进封装CoWoS转向SoIC (系统集成单芯片)技术。由于NVIDIA、AMD及苹果都将在未来推出基于SoIC设计的产品,台积电预期该技术将迎来庞大市场需求。
研调机构预估,台积电今年底SoIC产能将达1.5~2.0万片,明年翻倍扩张。SoIC能将多个Chiplet集成到单一高性能封装中,意味CPU、内存、I/O等不同类型的芯片都可以安装在同一个芯片上,提供更大的设计弹性,并针对特定应用进行优化。目前在AMD 3D V-Cache处理器可见到SoIC的应用,而NVIDIA和苹果似乎也计划跟进。
NVIDIA Rubin架构将率先导入SoIC设计,其Vera Rubin NVL144平台据称将配备Rubin GPU,内置两颗接近光罩(Reticle)大小的芯片,FP4运算性能可达50 PFLOPS,并搭载288GB的HBM4;更高端的NVL576平台则将搭载Rubin Ultra GPU,内置四颗光罩大小芯片,FP4运算性能达100 PFLOPS,并支持16个、共1TB的HBM4e。
据报道,苹果也计划导入SoIC,其下一代M5芯片将采用SoIC封装技术,并集成到苹果内部自研的AI服务器。虽然目前M5芯片详细资讯仍有限,但可以确定该芯片将应用于未来iPad和MacBook。
台积电预期到2025年底,SoIC产能将达到每月2万颗,但至少在NVIDIA Rubin上市前(预计2025年底至2026年初),台积电的主要封装重心仍会放在CoWoS技术。
(首图来源:台积电)










