
全球半导体设备大厂艾司摩尔(ASML)日前在一场公开活动中,公布了其新一代高数值孔径极紫外光(High-NA EUV,HNA)微影技术的最新进展与市场采用状况,目的在消除市场对其技术成功性的疑虑。而且,ASML也宣布,已在总部设立HNA专门组织并投入运行。
针对外界质疑HNA可能不会成功的市场传闻,ASML提供了公开数据以佐证其技术的迅速发展。最新量产型的HNA机台,型号为5200来取代早期系统,并已于2025年第二季交付给客户。当前,HNA机台的实际应用量正呈现指数型增长。截至2025年9月份,使用HNA机台进行曝光的芯片数量已累积超过35万片。
ASML表示,HNA技术的核心优势在于其效率和成本节省。若使用传统的Low-NA EUV (LNA) 技术,要铺设某些图案可能需要经过三次LNA曝光步骤。然而,若使用HNA,实际上可以用一次互工的方式,取代原本的三张光罩或三次曝光。这项改进带来了显著的省时和省成本效益。此外,HNA能够实现过去相当难做的“2D大图案”(2D big pattern)曝光。传统曝光方式通常限制在1D(直线或横线)的图案,而HNA的出现使得2D图案的曝光成为可能。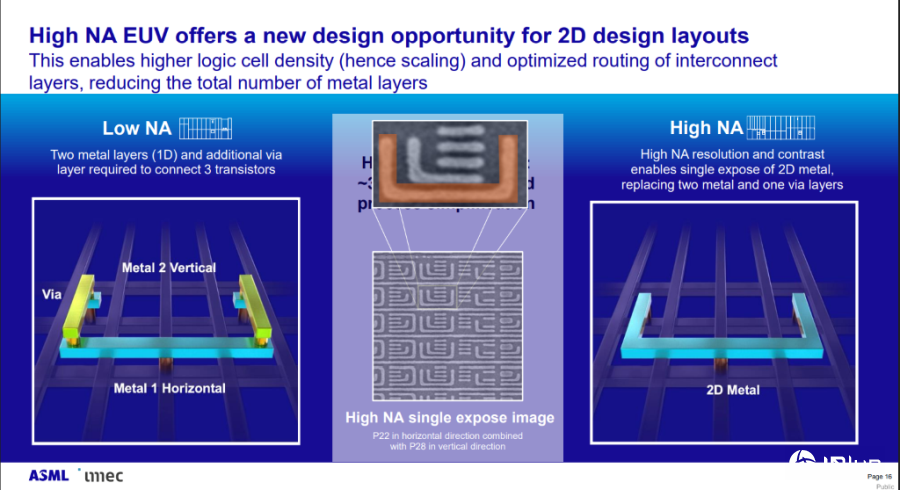
而在客户采纳方面,ASML透露,包括Intel、IBM以及三星等多家主要半导体制造商正在使用HNA。其中,Intel的公开声明指出,HNA在瑕疵率(defectivity)和良率(yield)上,基本上已做到与LNA相同的水平。鉴于HNA目前仍处于初期发展阶段,这显示其具有实现更好性能的巨大潜力。ASML对HNA的市场采用情况表示非常有信心。
ASML指出,HNA与LNA之间最主要的设计差异在于镜片或镜面的设计。HNA通过减少镜面数量来优化系统。这一设计至关重要,因为每一次光线在镜面上的反射都会导致光源损耗,例如100的光源进入后,第一次反射可能只剩90,再出来可能只剩81,损耗不断累积。因此,镜面数量越少,对系统性能的表现越有利。另外,EUV光线本身具有特殊性,它无法在空气环境中存在,因为会被空气吸收。因此,EUV设备中的所有光学组件(镜子)表面都经过多层处理,大约镀有80层材料以减少损耗。
EUV光学系统对精度的要求达到了极致。镜面的精度(accuracy)需要控制在20皮米(picometer)的等级,即千分之一纳米。为了说明这种精度的概念,如果将EUV镜子放大到像德国这么大,其最高点与最低点之间的差距仍会小于0.1毫米(实际上是0.00几毫米,极其微小)。在微观世界中,有一个不变的法则:越小的东西越难制作。而值得注意的是,EUV曝光机(无论LNA或HNA)采用的是反射式系统。光线无法穿透镜子。与之对比,所有DUV(深紫外光)技术的世界中,则采用透射式(折射)设计,光线会穿通过透镜。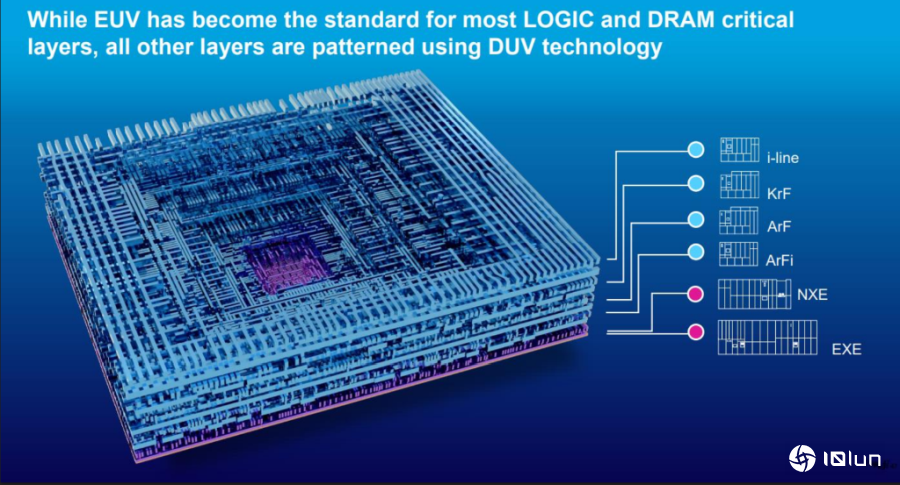
尽管EUV技术在处理芯片底部最关键的结构上至关重要,但从总体曝光量(Volume)来看,绝大部分的芯片处理仍是通过DUV(深紫外光)进行曝光的。根据统计,虽然EUV的重要性日益增加,但从2024年的占比来看,EUV仍然只占整个芯片曝光量中的一小块。DUV和其他产品线的经济效益对ASML而言至关重要,因为客户很大一部分的生产成本仍然集中在DUV这一块。
所以,ASML的DUV产品线持续升级。首先在浸润式(Immersion)微影部分,最新机台为2150。该机台的性能显著提升,每小时芯片处理量(WPH)可达到约310片。其机对机套准(MCH machine overlay)相较前一代也有显著提高。另外,也开发出KRF DUV机台。因为KRF DUV仍是非常重要的机台,已于2024年底开始出货。其生产效率更高,WPH可超过400片/小时,速度极快。
ASML强调,DUV与EUV在实际生产中需要相互配合。一片逻辑芯片大约需要进行70次左右的曝光,其中可能十几片使用EUV,而剩下的则使用DUV。因此,所有层次之间都需要进行精准的匹配(matching factor),这涉及到精确的套准(overlay),其精度皆以纳米为单位计算。无论是单机的套准(overlay)、机对机的套准,最终全部加总起来的结果就是产品上的套准(on product overlay),确保了芯片结构的精准叠加。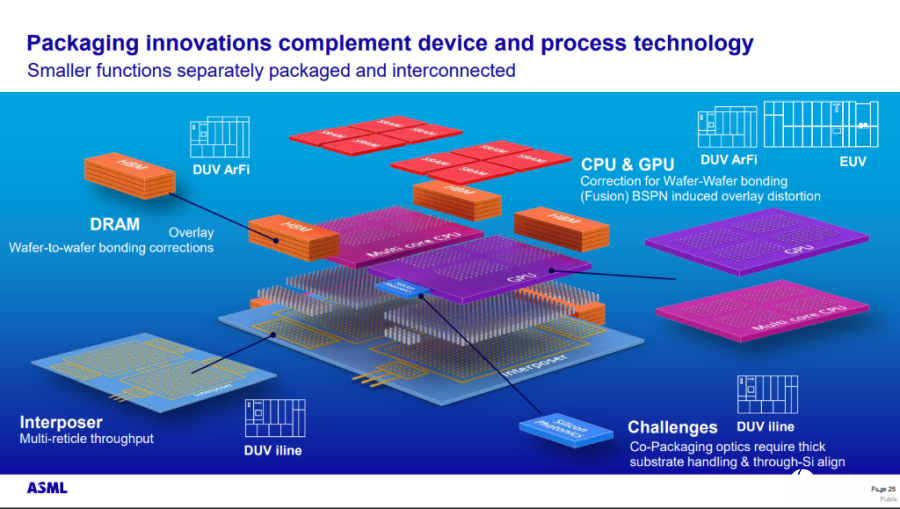
整体来说,ASML的高数值孔径EUV(HNA)正迅速从研发走向商业化,提供了更高的效率和先进的图案化能力。然而,深紫外光(DUV)技术因其庞大的产能占比和成本效益,在芯片制造流程中仍然扮演着不可或缺的多数角色。半导体制造业正处于EUV引领极致微缩,同时DUV承担大量生产的双轨并行阶段。
(首图来源:ASML)











