
Intel在Panther Lake与Clearwater Forest处理器采用模块化设计,搭配EMIB与Foveros等封装技术,将不同制程的模块集成为单一芯片,让我们深入了解这些技术的特点。
随着芯片设计越来越复杂,采用先进制程的成本也日益提高,导入模块化设计的需求也随之增加。
模块化设计具有多重优势,首先它能够提供更高的可扩展性,以Clearwater Forest处理器为例,能够依照不同型号的需求配置数量各异的运算模块(Compute Tile),而不用针对每款型号重新设计,大幅简化高、中、低端产品的开发流程。
另一方面,模块化设计也具有能够沿用既有模块(Tile)或小芯片(Chiplet),以及在单一芯片中混合搭配多种不同制程,达到控制整体开发与生产成本的功效。
同样以Clearwater Forest处理器为例,它的沿用前代处理器的I/O模块(I/O Tile),并使用Intel 18A、Intel 3、Intel 7等3种不同的制程节点,在负载最大的运算模块使用最先进的制程以节省运行时的电力消耗,而在运行速度较慢的I/O模块则使用较成熟的制程以降低生产成本。
 Intel除了将先进封装列为AI时代的技术支柱,也将Intel 18A制程的RibbonFET与PowerVia技术,以及硅光子、扩展与堆栈列入其中。
Intel除了将先进封装列为AI时代的技术支柱,也将Intel 18A制程的RibbonFET与PowerVia技术,以及硅光子、扩展与堆栈列入其中。
 Intel在过去几代的产品中,已经通过先进封装在单一芯片上集成多种不同制程之模块。
Intel在过去几代的产品中,已经通过先进封装在单一芯片上集成多种不同制程之模块。
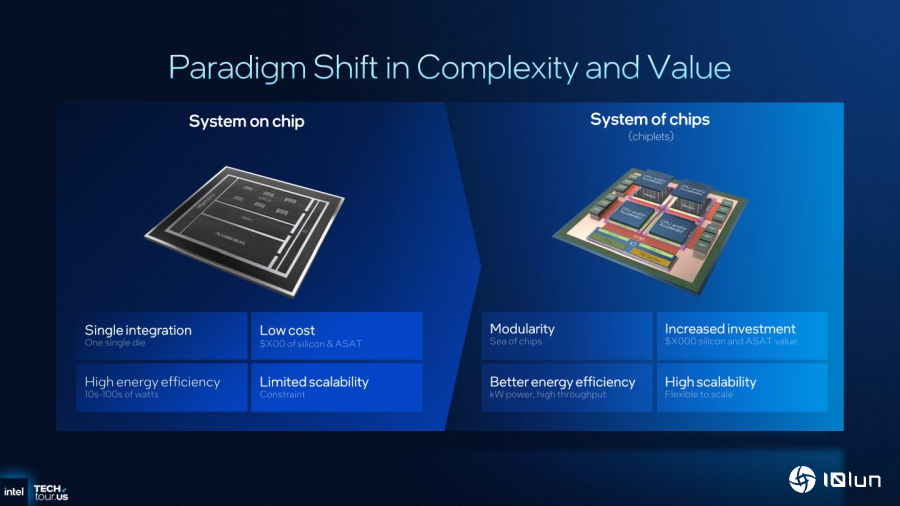 结合模块搭配先进封装的模块化设计有利于提高产品的可扩展性、设计弹性,并对成本管控有所帮助。
结合模块搭配先进封装的模块化设计有利于提高产品的可扩展性、设计弹性,并对成本管控有所帮助。
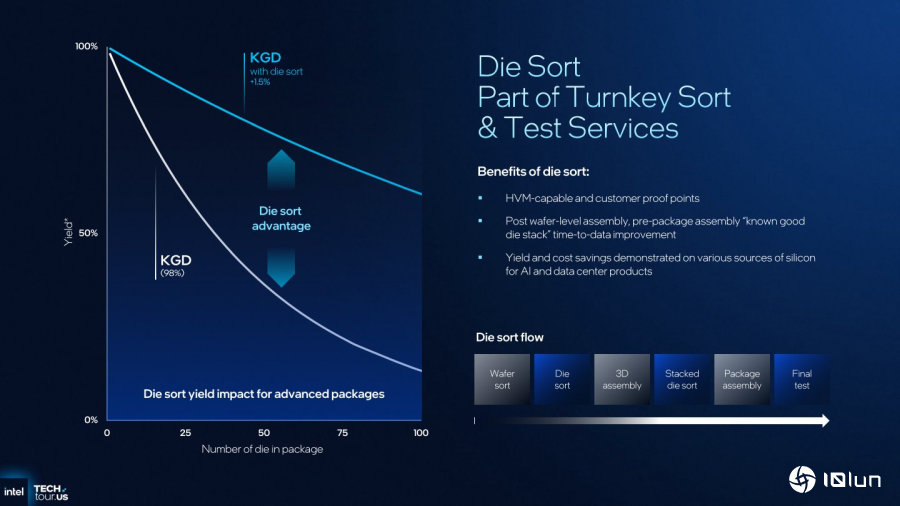 芯片在封装前的各阶段会先经过多次测试,并筛选掉不良裸晶,能够提升良好裸晶(Known Good Die,KGD)之比例,进而改善整体良。
芯片在封装前的各阶段会先经过多次测试,并筛选掉不良裸晶,能够提升良好裸晶(Known Good Die,KGD)之比例,进而改善整体良。
Intel具有FCBGA、EMIB、Foveros与多种衍生版本之先进封装技术,能够依照芯片的应用需求以及模块的特性选择不同封装方式,组合出更符合使用场景的配置。
FCBGA 2D与2D+封装技术已发展数十年,至今仍适用于低成本且对高速或低功耗等不同需求的产品,目前仍占据相当大的产能。其中2D+封装为基板堆栈技术,适用于网络交换机等接脚数高但芯片尺寸相对小的应用,可将封装分为多层以便冷却,对数据中心及网络市场的部分领域具高价值。
EMIB先进封装则为高性能计算所设计,在单一基板上连接多个芯片、内存及I/O组件,具有低成本、高性能之特色,适合应用于数据中心复合芯片。EMIB 3.5D不仅能通过EMIB技术连接同层芯片,还能连接堆栈多层的芯片,提供更高的设计弹性及更小的外形尺寸,尤其适用于高复杂度的芯片,且堆栈的混合键合界面能带来更佳的性能。
Foveros先进封装之中的Foveros 2.5D与3D先进封装属于堆栈技术,采用Co-EMIB技术连接主动或被动中介层上的芯片,点距可缩小至20微米以下,儿Foveros Direct 3D技术进一步完全采用混合键合技术,完成微米级点距、超高带宽及低功耗互联等特色。
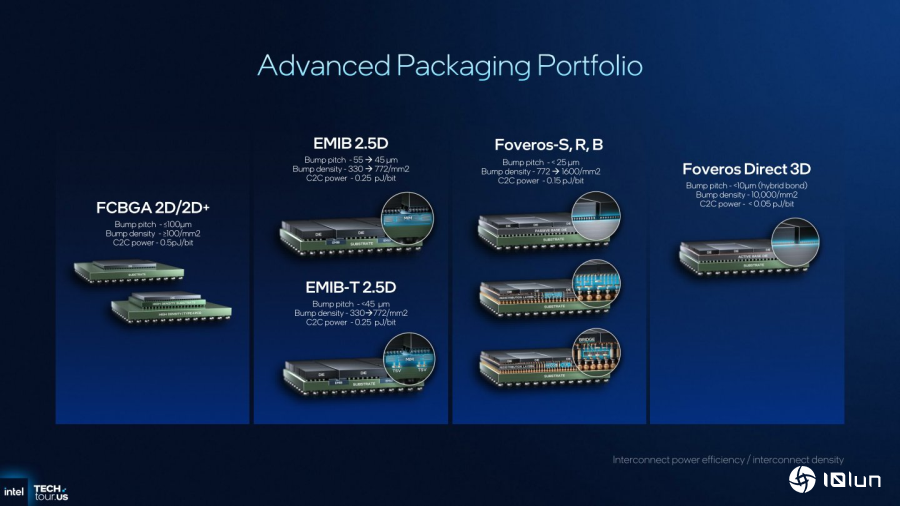 Intel具有FCBGA、EMIB、Foveros与多种衍生版本之先进封装技术。
Intel具有FCBGA、EMIB、Foveros与多种衍生版本之先进封装技术。
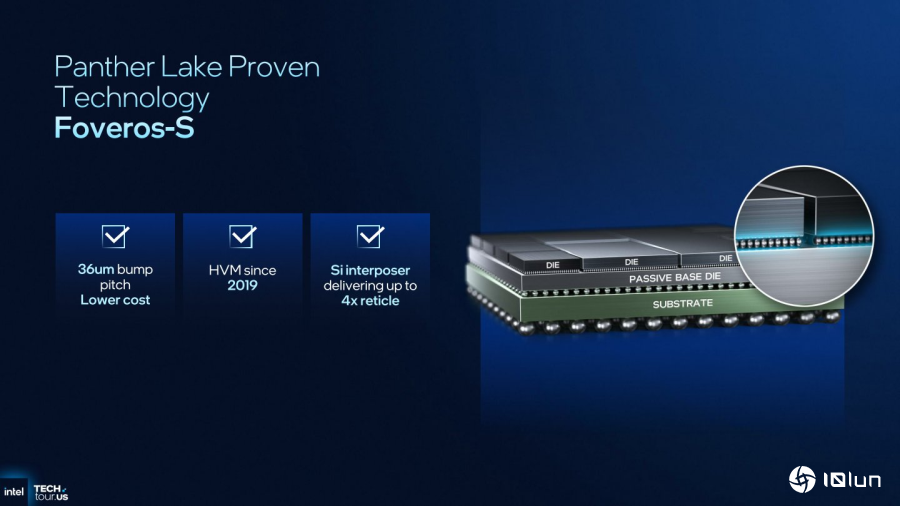 Panther Lake处理器采用Foveros-S封装,通过不具逻辑运算功能、只有信号路由的被动式基底裸晶(Passive Base Die)连接各模块并进行信号传输。
Panther Lake处理器采用Foveros-S封装,通过不具逻辑运算功能、只有信号路由的被动式基底裸晶(Passive Base Die)连接各模块并进行信号传输。
 Clearwater Forest处理器使用EMIB与Foveros Direct 3D等2种封装技术。Foveros Direct 3D负责连接运算模块与基底模块,而EMIB负则连接基底模块与I/O模块。其中基底模块属于主动式设计,除了信号传输功能之外,也提供末端缓存内存(Last Level Cache,LLC)功能。
Clearwater Forest处理器使用EMIB与Foveros Direct 3D等2种封装技术。Foveros Direct 3D负责连接运算模块与基底模块,而EMIB负则连接基底模块与I/O模块。其中基底模块属于主动式设计,除了信号传输功能之外,也提供末端缓存内存(Last Level Cache,LLC)功能。
 EMIB在2019年开始投入大量生产,采用45 um(微米)之连接点距。
EMIB在2019年开始投入大量生产,采用45 um(微米)之连接点距。
 Foveros Direct 3D则将点距缩小至9 um,以铜线直接连接的方式也有助于降低数据传输的电力消耗,每位元大约只需0.05 pJ(Pico Joule,皮焦耳)之电力。
Foveros Direct 3D则将点距缩小至9 um,以铜线直接连接的方式也有助于降低数据传输的电力消耗,每位元大约只需0.05 pJ(Pico Joule,皮焦耳)之电力。
 Foveros Direct 3D于这次推出的Clearwater Forest处理器首次投入大量生产。
Foveros Direct 3D于这次推出的Clearwater Forest处理器首次投入大量生产。











