
市场对电子产品的需求日益提升,包括智能手机、AI服务器和云计算数据中心,都要求高性能且小型化的IC芯片。(数据源:闳康科技)

为提升半导体芯片运算速度,增加组件积集密度并降低功耗,半导体组件不断的缩小,自1980年代的3μm制程以来,技术已进展至目前的3nm鳍状晶体管(FFET)与纳米片(nanosheet)的环绕式闸极(gate-all-around , GAA)晶体管,如图1所示,最先进的制程已成功进入3nm以下的量产技术节点。
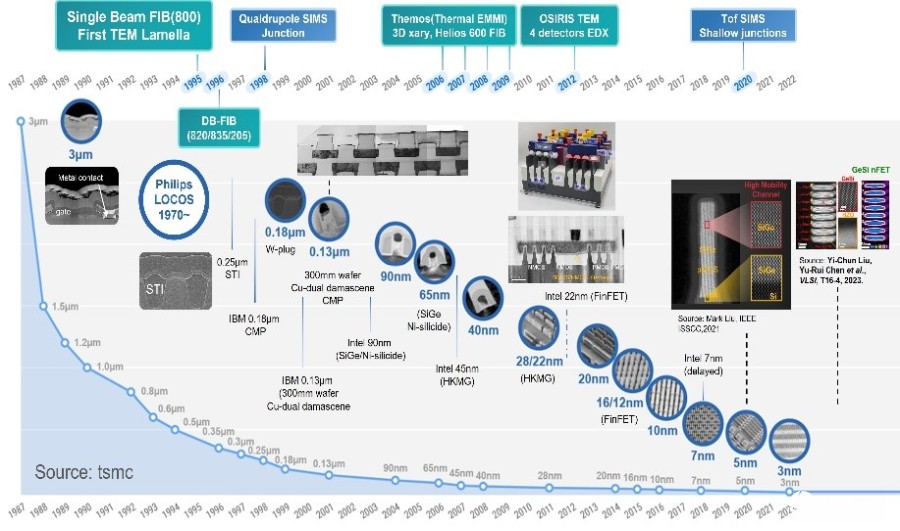
图1、半导体制程演进与分析技术的应用
顶尖半导体应用芯片除了需要优异的IC电路设计外,更需要完美的纳米组件结构搭配新时代或先进的半导体制程技术,达到芯片最佳的性能表现。制程常见的材料包括Strain Si (SiGe/SiP),Gate Oxide,电介质,控件特性的离子植入硼(B),磷(P),砷(As)等材料,而这些材料或组件的检测需要用到的分析技术包括两方面:(1)高空间分辨率(小于1nm)或(2)侦测到低成分浓度(小于ppm)的高端分析技术,本文主要介绍二次离子质谱仪(SIMS)在IC制程的品管监控的成分分析应用案例。
应变工程中的SiGe与SiP成分分析对组件性能的影响Si MOSFET组件制程微缩的演进中,如何增加信道中电子及电洞移功率(mobility) 是提升组件性能的重要课题。应变工程(Strained Engineering,Strained-Si)是提升Si纳米组件性能最有成效的方法,应变工程中常用SiGe材料来增加PMOS信道的压应力,增加电洞的移功率;而SiP材料则用来增加NMOS信道的拉应力,降低接触电阻,增加电子的移功率,不管是SiGe或是SiP等材料,微小的成分变化会大幅影响应变的程度,因此如何精确的侦测分析SiGe与SiP的成分,同时分析微量的掺杂成分,需要使用SIMS来分析,图2显示SiGe与SiP的SIMS纵深分析结果。

图2、SIMS应用于Strain Si (SiGe & SiP)的纵深分析
高介电常数材料SiON在MOSFET中的应用与成分分析金氧半场效晶体管(MOSFET)里的闸氧化层是金属闸极控件信道开关的重要绝缘材料,并且也是控制闸极漏电重要的结构材料,此闸氧化层的介电常数越高,对整个组件的特性越好,在组件实际应用的高介电常数材料,依照不同组件需求及制程节点(Node)会选择不同高介电常数材料当作闸氧化层,其中Oxynitride(氮氧化硅,SiON)为常用的高介电常数材料。SiON的用途很多,如闸氧化层、扩散阻障层、蚀刻终止层(Etching Stop Layer)、闪存(Flash)、动态随机访问内存(DRAM)等用途,每一种用途的SiON材料的氧(O)、氮(N)等成分含量会因为不同制程、不同需求而有不同含量,图3为使用SIMS分析高介电常数材料Gate Oxide (SiON)的案例。
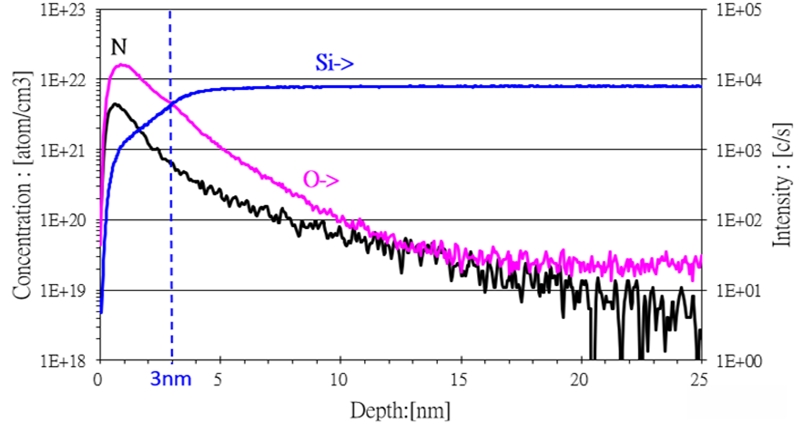
图3、高介电常数材料Gate Oxide (SiON)常用在半导体组件中金氧半场效晶体管(MOSFET)里的氧化层,厚度为数十到数纳米之间。
BPSG(硼磷硅玻璃,Boro-phospho-silicate Glass)材料的组成与制程参数的重要性分析在半导体制程中,前段制程(FEOL, Front End of Line)涉及到组件的制造,而后段制程(BEOL, Back End of Line)则关注于金属导线和绝缘介电层的制作。这两部分通过接触窗(Contact)中的导电材料相连,而填充的非导电介电材料则称为ILD(Inter-Layer Dielectric)。中段制程(MEOL, Middle End of Line)主要负责制作这些接触窗和填充材料。
由于前段制程完成后表面不平整,因此需要使用具有良好填充能力的材料来填补这些不平整的区域。这些材料也必须具备适当的绝缘能力。常用的填充材料之一是BPSG(硼磷硅玻璃,Boro-phospho-silicate Glass),它是硅玻璃中加入了硼(B)和磷(P)元素。B和P的含量及比例会影响材料的流动性和填充能力,进而影响后续的蚀刻制程参数。因此,了解B和P的含量、分布及成分比例对于制程中的材料选择至关重要。图4显示了BPSG的SIMS分析结果,有助于我们掌握这些关键参数。

图4、 BPSG (硼磷硅玻璃,Boro-phospho-silicate Glass)的SIMS分析结果
低介电常数材料FSG(氟化硅玻璃)在后段制程中的应用与成分分析前面提到后段制程(BEOL,Back End of Line)是指制作金属导线及绝缘的介电层材料的部分。实际制程需求为金属导线需要低电阻材料,绝缘的介电层材料需要低介电常数(Low-k)的材料,利用此两种材料来降低整个IC的电阻电容延迟(RC-Delay)。低介电常数的材料通常是将氧化硅中加入C(碳)或F(氟)等元素以降低介电常数,因此加入多少的C或F是影响材料介电常数的重要因素,FSG是常用的低介电常数(Low-k)材料之一,FSG就是氧化硅中加入F(氟)元素来降低材料的介电常数,图5是利用SIMS精确测定FSG中的F含量的范例。

图5、FSG的SIMS纵深分析结果
三元功能薄膜材料SiCN的特性与成分分析SiCN是一种新型的三元功能薄膜材料,拥有多项优异特性,包括高硬度、宽光学带隙、以及优良的高温抗氧化和抗腐蚀性能。这些特性使SiCN在IC(集成电路)、LCD(液晶显示器)、FPD(平板显示器)和光电组件等领域中具有广泛应用潜力。SiCN的性能受其C/N比例及均匀性影响很大,这使得精确分析其成分变得至关重要。图6展示了SiCN的SIMS分析结果,帮助我们深入了解这些关键参数如何影响材料性能。
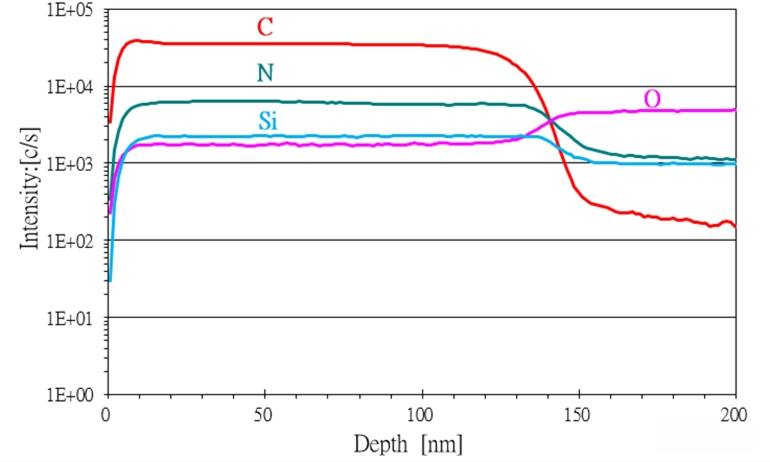
图6、 SiCN的SIMS纵深分析结果
Backside SIMS分析在金属层扩散研究中的应用与优势在半导体分析中,Backside SIMS(背面二次离子质谱仪)是一种强大的技术,尤其在处理金属层的扩散问题时表现出色。一般来说,当我们从表面进行分析时,少量金属可能会在分析过程中被推入下层,造成数据误差(knock-in效应)。而使用Backside SIMS技术,通过分析基板的背面,可以避免这一问题,提供更准确的金属成分纵向分布。这种方法需要先将基板减薄,确保分析面平整,并且要求高超的样品制备技术。图7展示了使用Backside SIMS和传统表面分析方法进行铜扩散研究的对比结果。

图7-1、 一般从表面SIMS分析时,会将铜在分析过程中因SIMS离子束渐射被推入下层

图7-2、 Backside SIMS分析则可真实呈现铜扩散的分布,且有良好的纵深分辨率
TOF-SIMS在有机污染物分析中的应用与案例研究在有机物分析中,傅立叶变换红外光谱仪(FT-IR)通常是首选方法。然而,当有机污染物仅存在于浅表层时,FT-IR的信号可能过于微弱,难以检测。此时,飞行时间式二次离子质谱仪(TOF-SIMS)就显得格外重要。TOF-SIMS能通过质谱分析比较正常样品与异常样品(或怀疑污染物),从而确定有机污染源。图8展示了一个TOF-SIMS在有机污染分析中的案例。通过质谱比对,我们成功识别出污染源为封装过程中的硅油,这些污染物导致Epoxy无法正常附着在芯片上。
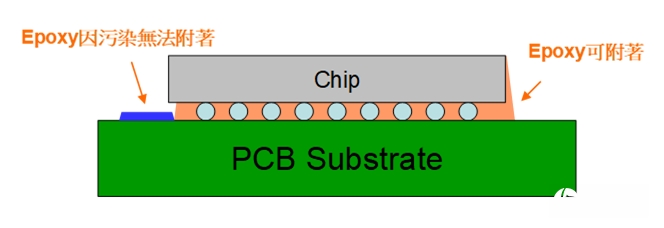
图8-1、 封装过程中因有机污染物残留造成Epoxy无法正常附着在芯片上

图8-2、 经由TOF-SIMS表面质谱的分析比对,判断污染物为硅油
二次离子质谱仪(SIMS,Secondary Ion Mass Spectrometry) 是一种先进的分析工具,用于精确测量材料的成分。其工作原理是:首先,带有能量的离子束轰击样品,激发出二次离子。这些二次离子被加速后进入质谱分析系统,通过电场和磁场的偏转,根据质荷比(m/e)分离不同的离子,以达到成分分析的目的。二次离子的强度转换为元素浓度,并且离子轰击时间可以用来分析材料的纵深分布。
SIMS具备极高的侦测灵敏度,能够测量固体材料中的元素含量至百万分之一(ppm)或更低。SIMS主要有以下三种类型:
1. 磁偏式质谱仪(Magnetic-Sector SIMS):拥有最佳的侦测极限,非常适合进行微污染分析。2. 四极式质谱仪(Quadrupole-SIMS):提供良好的纵深分辨率,非常适合用于薄膜和超浅接面分析。
3. 飞行时间式质谱仪(TOF-SIMS):除了能分析有机物外,最新型号在纵深分析能力上也接近四极式质谱仪。
下表展示了三种SIMS仪器的特性比较,虽然每种仪器都有其独特的优势,但要选择最适合的分析工具仍需根据具体需求而定。闳康科技拥有全面的SIMS机型和丰富的实务经验,能够为客户提供全方位的表面分析服务。
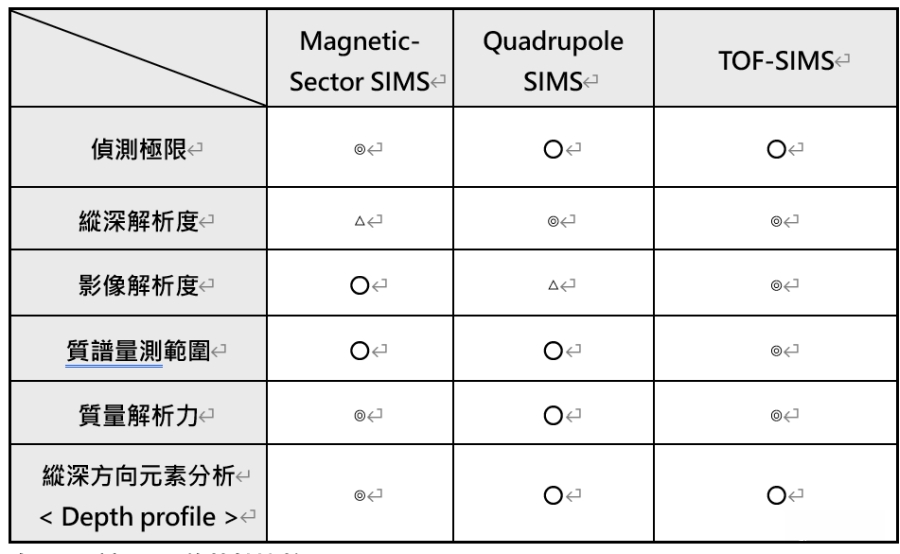
表一三种SIMS的特性比较

(首图来源:Shutterstock;数据源:闳康科技)










