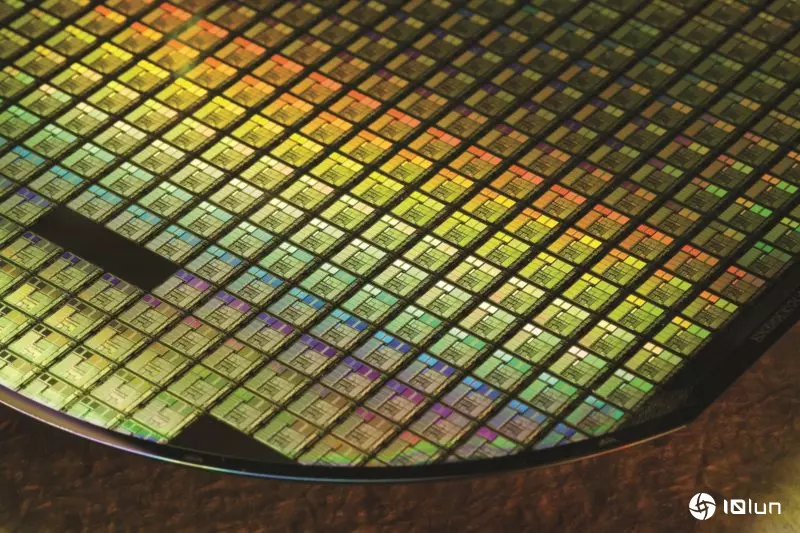
苹果2026年推出的iPhone 18系列将首度采用台积电2纳米制程,并计划由现行InFO封装转向WMCM方案。此举旨在通过封装革新提升良率、减少材料消耗,缓解先进制程带来的成本压力。
相较于现行InFO(集成扇出封装)采用PoP(Package on Package)垂直堆栈,将内存直接置于处理器上方,并采用Chip First制程在芯片上生成RDL(重布线层),再将内存封装于上层,WMCM(芯片级多芯片模块)则改为水平排列,并采Chip Last制程,先完成重布线层的制作,再将芯片安装于其上。
InFO的优势是集成度高,但随着AI应用带动内存容量需求大幅增加,内存模块叠得越高,封装厚度与制作难度都显著上升,同时SoC功耗提升也使散热变得困难。WMCM将内存与处理器并排放置,能在保持高性能的同时改善散热条件,并提供更大的内存配置弹性。
天风国际证券分析师郭明𫓹指出,长兴材料已获台积电采用,成为苹果2026年iPhone与Mac芯片时代中,供应液态封装料(LMC)与底填封装料(MUF)的厂商。MUF技术可将底填与封模制程集成为单一步骤,不仅减少材料用量,还能缩短生产时间并提升良率,直接支持苹果推行WMCM的策略。
业界认为,WMCM封装将为苹果带来更高的产品线灵活度,可将CPU、GPU与神经网络引擎分为独立模块进行组合,让A20与A20 Pro在性能差异化上更明显,同时加快不同产品线的研发与设计周期。
此外,苹果也在探索SoIC(System on Integrated Chips)堆栈方案,将两颗先进芯片直接堆栈,形成超高密度互联,以降低延迟并提升性能与能源效率。不过,SoIC技术预计仅会应用于2026年推出的M5系列MacBook Pro芯片,而非iPhone 18系列,显示苹果会依据不同产品的设计需求与成本结构,选择最适合的封装方案。
(首图来源:TSMC)










