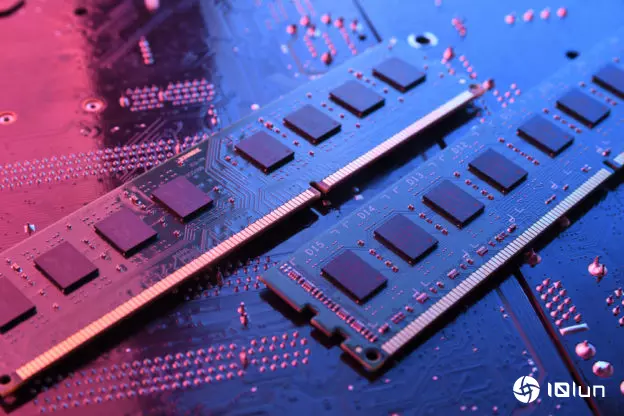
比利时imec(比利时微电子研究中心) 与根特大学(Ghent University)宣布,300毫米硅芯片上成功外衍生长120层Si/SiGe叠层结构,为推动3D DRAM的重要突破。
论文发表在 《Journal of Applied Physics》。传统DRAM制程缩小至10纳米级以下,电容体积不断缩小,导致电荷保存更困难、漏电问题加剧,业界普遍认为平面微缩已逼近极限。若要满足AI与高性能计算(HPC)庞大的内存需求,未来势必要借由“垂直堆栈”提升密度,概念与逻辑芯片的环绕闸极(GAA)类似,3D结构设计突破既有限制。
虽然HBM(高带宽内存)也常称为3D内存,但严格来说,属于芯片堆栈式DRAM:先制造多颗2D DRAM晶粒,再以TSV(硅穿孔)互联组合,本质上仍是2D。
真正的3D DRAM是像3D NAND Flash,单一芯片内直接把内存单元沿Z轴方向垂直堆栈。
过去,由于硅与硅锗(SiGe)晶格不匹配,一旦层数过多就容易出现缺陷,难以突破数十层瓶颈。这次imec团队加入碳元素,就像层与层之间涂一层“隐形黏胶”,有效缓解应力(stress),展现稳定性。
团队指出,成果证明3D DRAM材料层级具可行性。应力控制与制程优化逐步成熟,将来3D DRAM有望像3D NAND走向商用化,使AI与数据中心容量与能效都更高。
(首图来源:shutterstock)











